微电子用高性能苯并环丁烯硅树脂
发布时间:2014-03-14 09:09:38 作者:admin 浏览量:2795
1、项目主要内容
从大宗化工原料出发,经高温真空反应、溴代反应、单体合成、树脂制备四步工艺,可制备高性能苯并环丁烯硅树脂。现已具备小批量生产能力,四步工艺均成熟。该树脂具有高的热稳定性和化学稳定性、低的介电常数和介电损耗、优异的耐潮性能、高的薄膜平整性、优良的成膜性能和固化特性,与硅基片、金属等有很好的粘附性能。
2、项目主要应用范围
主要用于微电子工业领域,用做层间介电薄膜材料,微电子器件的封装材料,如大规模集成电路MCM、微电机系统MEMS等;用于液晶显示器的封装,高分子薄膜导波器等,应用范围十分广泛,属军民两用技术。
3、成果水平及专利情况
该项目已经形成3项专有技术(未申请专利),已申请5项专利,3项授权;每步工艺与国外相比均具有先进性和自主知识产权。
4、主要技术指标
介电常数(2.65 – 2.50 @1-20 GHz)
介电损耗 (0.0008 – 0.002 @1-20 GHz )
击穿电压(5.3×106 V/cm)
吸湿性(0.23%, 100℃沸水中24h)
分解温度(Td):420℃
初始分解温度(T0):350℃
玻璃化转变温度(Tg)>350 ℃
薄膜平整性>90%
5、成果转化的投资估算
投资金额依生产规模而定,设备投资100万元,可生产项目树脂>150公斤/月。
6、项目市场前景及经济效益分析
 随着微电子工业的飞速发展,相应的电子器件和集成电路正朝着小型化、高密度方向发展,出现了多芯片模块(MCM)和微电机系统(MEMS)等新技术。电路密度和功能的不断提升,对封装技术提出了更多更高的要求,这样也大大促进了封装材料的发展。封装材料已从过去的金属和陶瓷封装为主转向塑料封装,至今塑料封装已占到整个封装材料的98%,其中封装成本占器件成本的30%左右。目前常用的塑料封装材料主要以环氧树脂和聚酰亚胺为主,但二者都存在诸多材料性能和加工工艺方面的缺陷,高性能封装材料产业化已成为促进我国电子工业快速发展的迫切要务。项目产品主要用于高端微电子器件的介电薄膜和封装,显示了十分优异的综合性能,国外在军用、民用已得到广泛应用。目前国内无销售,国外对中国限售。产品成本低、附加值高,经济效益显著。
随着微电子工业的飞速发展,相应的电子器件和集成电路正朝着小型化、高密度方向发展,出现了多芯片模块(MCM)和微电机系统(MEMS)等新技术。电路密度和功能的不断提升,对封装技术提出了更多更高的要求,这样也大大促进了封装材料的发展。封装材料已从过去的金属和陶瓷封装为主转向塑料封装,至今塑料封装已占到整个封装材料的98%,其中封装成本占器件成本的30%左右。目前常用的塑料封装材料主要以环氧树脂和聚酰亚胺为主,但二者都存在诸多材料性能和加工工艺方面的缺陷,高性能封装材料产业化已成为促进我国电子工业快速发展的迫切要务。项目产品主要用于高端微电子器件的介电薄膜和封装,显示了十分优异的综合性能,国外在军用、民用已得到广泛应用。目前国内无销售,国外对中国限售。产品成本低、附加值高,经济效益显著。
图1 . 苯并环丁烯硅树脂的薄膜平整性
(平均面粗造度:RA 0.43 nm,
最大高低差P-V:4.4 nm, 均方根粗造度:0.54 nm)
7、拟合作方式
技术转让或产品定制。
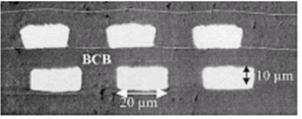 |  |
图2. MEMS中苯并环丁烯树脂(BCB)和聚酰亚胺树脂(PI)做为介电膜时的平整度比较

